央视聚焦!李财富课题组:研发半导体封装关键材料,赋能高功率半导体器件发展
近日,中山大学材料学院李财富副教授带领的先进电子封装与技术研究团队,凭借半导体封装领域的突破性成果登上央视财经频道《经济半小时》“启航!2026:新赛道‘领跑’”栏目,成为解读“创新驱动培育新质生产力”的生动科研样本。

“我爱材料学院”标识

李财富登上央视财经频道《经济半小时》栏目
科研攻坚:
破解“卡脖子”难题的自主创新
随着新能源汽车、5G基站、“东数西算”等国家战略的深入推进,高功率器件对封装材料的性能要求愈发严苛。传统锡基材料已无法适配 200℃-300℃的高温工作环境,而微米银焊膏凭借其优异的导电、导热性能,并能够实现“低温烧结,高温服役”,逐渐成为高功率半导体器件中不可或缺的关键互连材料。但我国高性能焊膏等关键材料长期依赖进口,在一定程度上制约我国半导体产业链的自主可控。
李财富带领的课题组所开展的核心工作,正聚焦于高端半导体封装用关键材料的研发与产业化攻关。团队针对我国半导体产业“卡脖子”的封装材料难题,长期深耕用于高功率器件的封装基板、高性能互连材料等方向,通过调控材料的微观结构、有机溶剂的适配性和烧结工艺参数,成功研发出具有自主知识产权的高性能银、铜焊膏,可适配先进封装技术的应用需求。

配置微米银焊膏
性能硬核:
“小焊点”承载“大重量”
芯片互连材料作为功率器件的关键组成部分,其性能直接决定器件的电性能、散热效率与整体可靠性。它承担着连接高功率芯片与基板的“超级连接器”的重要使命。李财富在采访中介绍,微米银焊膏经剪切强度测试显示,烧结后的银焊点剪切强度远超演示所采用的推拉力试验机900N的最大量程 —— 这意味着在一片微小芯片上悬挂90公斤重量,焊点仍不会脱落断裂,性能达到国际先进水平。
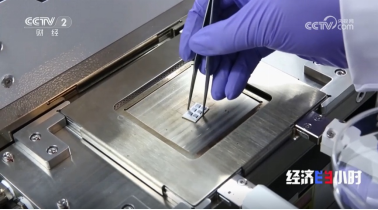
芯片/银焊膏/基板样品进行烧结
这项研发成果兼具重要科学价值与社会价值。从科学层面看,其突破了高温环境下半导体封装材料的性能瓶颈,明确了功率电子器件失效核心诱因的解决方案,为半导体领域互连材料研发提供了关键技术参考;从社会层面看,该材料能够助力打破国外技术与供应垄断,为保障我国高功率器件供应链安全贡献力量,并为新能源汽车、5G基站、算力基础设施、电力传输、储能、轨道交通、航空航天等战略领域的高质量发展提供了有力材料支撑。

李财富课题组—先进电子封装材料与技术研究团队
产学研融合:
从实验室走向产业一线
将实验室配方转化为产业可用的核心材料,需攻克 “最后一公里” 的工艺难题。银焊膏的预热温度、烧结气氛、升温速率等参数组合多达数千种,李财富课题组通过反复试验与系统优化,成功探索出最优工艺方案,让自主研发的焊膏具备了规模化生产与应用的条件。
展望未来,李财富课题组将持续推进高功率电子封装材料银焊膏、铜焊膏及封装基板材料的开发、应用验证与产业化推广工作,力争让更多研究成果赋能未来产业,为我国高端制造业自主化发展贡献学术力量。

